摘要 化學機械拋光(CMP)已成為公認的納米級全局平坦化精密超精密加工技術。拋光液在CMP過程中發揮著重要作用。介紹了CMP過程中拋光液的作用的研究進展,綜合歸納了拋光液中各組分的作用,為拋光液的研制和優化原則的制定提供了參考依據。
關鍵詞 化學機械拋光(CMP);拋光液;材料去除率;表面質量
化學機械拋光(Chemical mechanical polishing,簡稱CMP),又稱化學機械平坦化(Chemical mechanical planarization),是提供超大規模集成電路(ULSI)制造過程中表面平坦化的一種新技術,于1965年首次由美國的Monsanto提出,最初是用于獲取高質量的玻璃表面[1]。CMP技術將磨粒的機械研磨作用與氧化劑的化學作用有機地結合起來,可實現超精密無損傷表面加工,滿足集成電路特征尺寸在0.35μm以下的全局平坦化要求。CMP過程是一個動態的微細加工過程,在該過程中,拋光液中的化學組分與工件發生反應,在工件加工表面形成一層很薄、結合力較弱的生成物;而拋光液中磨粒在壓力和摩擦作用下對工件表面進行微量去除。此外,拋光過程拋光液還通過在拋光區域形成流體膜以及帶動磨粒在拋光區運動影響拋光過程。所以,拋光液在CMP過程中影響著化學作用與磨粒機械作用程度的比例,影響著拋光區域的溫度,在很大程度上決定著CMP能獲得的拋光表面質量和拋光效率。
CMP拋光液一般由去離子水、磨料、PH值調節劑、氧化劑以及分散劑等添加劑組成[2]。我們介紹了CMP過程中拋光液的作用的研究進展,綜合歸納了拋光液中各組分的作用,為拋光液的研制和優化原則的制定提供了參考依據。
1 拋光液及其組分的作用
1.1 磨料
磨料在拋光過程中主要通過微切削、微劃擦、滾壓等方式作用于工件被加工表面,去除表面材料。最理想的CMP過程是磨料的機械去除表面材料厚度等于化學反應生成物層厚度,此時,磨粒只需較小的機械作用去除結合力較弱的化學反應層的生成物,可減少或避免拋光表面缺陷。磨料的硬度、粒徑、形狀及其在拋光液中的質量濃度等綜合因素決定了磨粒的去除行為和能力。
磨料相對工件的硬度對磨料的作用機制有著重要影響。M.Hutchings等人[3]研究了在靜態壓力作用下,磨料與工件拋光表面變形的關系,并指出當磨粒硬度相對工件太大時,在拋光壓力作用下很容易導致磨粒嵌入工件表面,在拋光表面殘留劃痕、磨蝕坑(見圖1)。陳志剛等人[4]等人研究了納米CeO2、Al2O3、SiO2磨料拋光硅片的效果,結果表明拋光過程中納米磨料所發生的自身變形量與磨料的硬度成反比,硬度低的納米磨料由于自身變形量大,其切入工件的深度小,工件拋光表面粗糙度低。

磨料在粒徑大小可影響到磨粒的壓強及其切入工件的深度。一般來說,在拋光過程中,粒徑大的磨粒壓強大,機械去除作用較強,材料去除率較高。所以粒徑較大的磨粒容易在拋光表面產生較大的殘留劃痕甚至殘留裂紋;而粒徑較小的磨粒可獲得較好的拋光表面質量。劉金玉等人[5]分析了化學機械拋光過程中拋光液中磨料的作用機理,研究了拋光液中SiO2磨料粒徑對藍寶石襯底拋光速率的影響,并得到了在堿性環境下隨著SiO2磨料粒徑(20~70nm)增大,藍寶石襯底拋光速率明顯增加,而其表面逐漸出現劃痕,表面粗糙度越差的結論。Jianfeng Lou等人[6]通過研究發現,在一般情況下,磨粒大小分布函數影響著活性磨粒的數量及尺寸,從而影響著材料去除率,并且大多數情況下,磨粒大小分布符合正態概率密度函數。Dincer Bozkaya[7]研究發現,當大顆粒尺寸的磨粒及其質量濃度增大到一定時,工件表面的氧化膜缺陷明顯,并且CMP機理也會相應的變化,所以為獲得理想的拋光效果,必須采取有效的方法來減少拋光液中大顆粒磨料的存在。
Mazaheri等人[8]通過實驗研究了CMP中磨粒的表面形狀對材料去除率的影響,結果發現粒徑相同的情況下,球形磨粒的滲透深度比表面不平的磨粒小,但其材料去除率比后者大。
1.2 PH值調節劑
拋光液中常常添加一些化學試劑用于調節拋光液的PH值,以保證拋光過程化學反應的進行,CMP拋光液一般分為酸性和堿性兩大類。
酸性拋光液最早是由化學腐蝕液改進而來的,具有溶解性強、氧化劑選擇范圍大、拋光效率高等優點,常用于金屬材料的拋光。酸性拋光液的PH值一般為4左右,可通過加入有機酸作為PH調節劑[9]。其缺點是腐蝕性強,對拋光設備要求高,選擇性較低,但是可加入抗蝕劑苯并三唑(BTA)來提高其選擇性,不過BTA的引入會影響拋光液的穩定性。張偉等人[10]通過X射線光電子能譜儀和電化學分析等手段研究了拋光液中BTA緩蝕劑在銅化學機械拋光過程中的作用機制,結果表明,采用檸檬酸將拋光液調節為PH=4時,氧化劑(H2O2)在酸性環境中氧化能力強,銅的去除率大,添加的BTA能與銅表面相互作用生成一層保護膜,提高了拋光液中銅陽極溶解的平衡電位,抑制了氧化劑對銅表面的腐蝕,從而降低了銅拋光表面粗糙度。
堿性拋光液具有選擇性高、腐蝕性弱等優點,一般用于非金屬材料的拋光。堿性拋光液的PH值往往在10~11.5范圍內,常采用添加無機堿如KOH、NaOH或NH4OH等作為PH值調節劑,但其不足之處是在堿性溶液中很難找到氧化性強的氧化劑,因而拋光效率很低[9]。楊金波等人[11]研究了PH值調節劑對CMP拋光硅片的材料去除率影響,結果表明采用KOH將拋光液的PH值調節在10~11.5范圍,材料去除率隨PH值的增加而增大。汪海波等人[12]探究了工藝條件對藍寶石化學機械拋光的影響,結果表明,采用KOH和HCI調節拋光液PH值時,隨著PH值(9~12)的升高,材料去除率增加,表面粗糙度先降低后升高(如圖2所示),并認為PH值影響了藍寶石表面形成的水化層,從而影響材料去除率和拋光表面粗糙度。
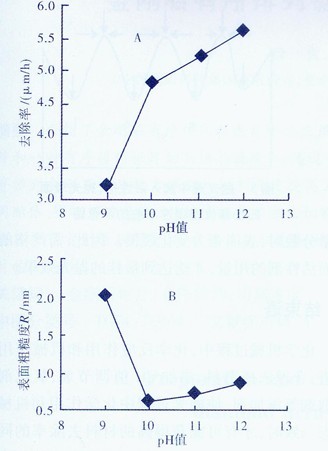
1.3 氧化劑
在拋光過程中,為了能夠較快地在拋光表面形成一層結合力弱的氧化膜,有利于后續的機械去除,常常會在拋光液中添加氧化劑。在氧化劑的氧化腐蝕和磨料的研磨共同作用下,被加工表面可達到高質量的全局平坦化效果。
不同的氧化劑對工件的氧化效果不同。董伯先[13]研究了用于化學機械拋光CVD金剛石膜的拋光液,分別采用過硫酸鉀、高鐵酸鉀、高錳酸鉀、雙氧水等十種氧化劑進行了實驗。結果表明,雙氧水在拋光液中不能穩定地存在,但添加氯化亞鐵可增強其穩定性;二氧化錳作為氧化劑的拋光效果最差,高錳酸鉀的最好,并認為機械作用刺激了化學反應,為化學反應的進行提供了所需要的能量。李巖等人[14]對碲鋅鎘晶體進行了化學機械拋光方法的嘗試性實驗,與過氧化氫和溴水比較,硝酸的氧化效果最好,拋光后可獲得Ra為1.1nm的超光滑無損傷表面,材料去除率為74nm/min,如圖3所示。
氧化劑的濃度也會對拋光效果產生影響。P.Wrschka等人[15]研究了CMP過程Al的氧化薄膜生產速率與材料去除率的關系,結果表明隨著氧化劑濃度的增加,氧化膜厚度變大,材料的去除率卻減少。
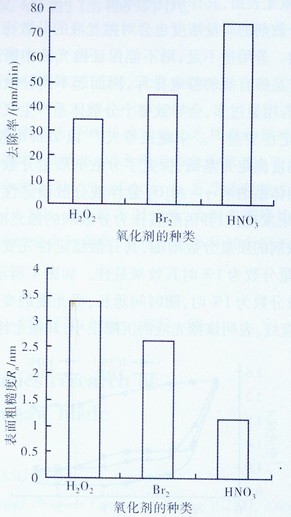
而Wei等人[16]研究了在不同濃度的氧化劑拋光液中,化學機械拋光銅時氧化薄膜與表面質量的關系,結果發現氧化膜的厚度與磨粒的大小是影響銅表面質量的最主要的因素。
1.4 分散劑
一般來說,對拋光液的基本要求是磨粒均勻地懸浮分散在拋光液中,且具有足夠的分布穩定性。所以在拋光之前有必要對拋光液進行過濾,濾掉磨料聚集產生的微量大尺寸磨料顆粒。然而,過濾并不能全部消除這種聚集現象,因為在拋光的實際過程中,工藝參數的變化會導致磨料的軟聚集,從而影響工件表面的拋光效果[17]。因此,往往需要在拋光液中添加分散劑來提高拋光液的分散穩定性,以減少溶液中磨料粒子團聚。
不同分散劑會對拋光液中磨粒的分散穩定性產生不同的影響。李慶忠等人[18]研究分散劑對銅CMP過程中材料去除率和表面粗糙度的影響時發現,添加適宜的分散劑,拋光液因其有效的分散作用可以降低拋光表面粗糙度和提高材料去除率,采用二乙烯三胺(質量分數0.05%)作為拋光液的分散劑拋光銅時,獲得了570.2nm/min材料去除率和表面粗糙度Ra1.076nm的拋光表面,其作用優于吡啶。
分散劑的質量濃度也會對拋光液的分散穩定性產生影響。若用量不足,則不能保證拋光液中磨料顆粒之間有足夠有效的靜電排斥,因而起不到分散穩定性作用;若用量過多,會導致整個分散體系產生氣泡或聚凝,穩定性變差[2]。宋曉嵐等人[19]以Zeta電位、潤濕性及黏度測定為基礎,探究了分散劑質量分數等因素對水相體系納米γ-Al2O3懸浮液分散穩定性能的影響,結果發現,以異丙醇胺作為分散劑的拋光液中,隨著分散劑的質量分數增加,其分散穩定性先變好后變差,質量分數為1%時,隨時間延長,吸光度的變化趨于一條直線,表明該拋光液的沉降很小,其穩定性最好。

1.5 表面活性劑
在拋光液中加入合適的表面活性劑,能夠改善拋光液的分散穩定性,使分散劑吸附在磨粒的表面,從而改變磨粒的表面性質,增強了顆粒間的排斥作用能[20]。李薇薇等人[21]認為表面活性劑既能滿足降低新生表面能量的要求又易于吸附后的清洗,同時促進了反應產物與的質量傳遞,如圖5所示。劉瑞鴻[2]進一步研究了當拋光接近尾聲時,由于整個工件表面吸附了一層表面活性劑,阻止了拋光液中氧化劑的進入,中斷了化學反應的進行,從而使得工件表面材料去除率很低,常稱之為“自停止”現象。
郭權峰[20]研究了表面活性劑的吸附模型和性質,結果表明一個較好的表面活性應該是在其質量分數較低時就能達到吸附飽和狀態,即質量分數較低時就有最低的表面張力。表明可以用達到最低表面張力時得質量分數大小來衡量表面活性劑的表面活性。
另外,表面活性劑質量分數對拋光液的性質有很大的影響。隨著表面活性質量分數的增加,拋光液的表面張力顯著減少,但當質量分數值達到某一臨界質量分數時,表面張力變化緩慢。因此,需嚴格的控制表面活性劑的用量,才能達到最佳的拋光效果。

2 結束語
化學機械過程中,化學反應作用和機械作用相互促進,合理選擇磨料、添加PH值調節劑、氧化劑以及分散劑等添加劑,使拋光過程中化學作用和機械作用動態一致時,才有可能獲得高的材料去除率的同時獲得好的拋光表面質量。因此,研究拋光液的組成原則對于合理配制不同材料的拋光液和優化選擇拋光工藝參數,對于完善CMP拋光理論具有重要作用。
參考文獻:
[1]張朝輝,雒建斌.化學機械拋光中的納米級薄膜流動[J].中國機械工程,2005,16(14):1282-1284.
[2]劉瑞鴻.二氧化硅介質層CMP拋光液研制及其性能研究[D].大連理工大學,2009.
[3] HUTCHINGS M. Friction and wear of engineering materials[M].CRC Press,1992.
[4] 陳志剛,陳楊.納米磨料硬度對超光滑表面拋光粗糙度的影響[J].中國有然金屬學報,2005,15(7):1075-1080.
[5] 劉金玉,劉玉嶺,項霞,等.磨料對藍寶石襯底去除速率的影響[J].工藝技術與材料,2010,35(11):1064-1066.
[6] LUO J F . Integrated modeling of chemical mechanical planarization/polishing(CMP)for intergrated circuit fabrication from particle scale to die and wafer scales[D].University of California,2003.
[7] DINCER B.Mechanica of the Pad-abrasive-wafer Contact in Chemi-cal Mechanica Polishing[D].Northeastern University,2009.
[8] MAZAHERI A R,AHMADI G.Modeling the effect of bumpy abrasive particles on chemical mechanical polishing [J].J Electrochemical Soc,2002,149(7):370-375.
[9] DU T B,DNYANESH Ti ,LUO Y,et al.Electrochemical character-ization of copper chemical mechamical plannarization in KIO3slurry[J].Applied Surface Sci-ence,2004,229:167-174.
[10] 張偉 ,路新春,劉宇宏,等.緩蝕劑在銅化學機械拋光過程中的作用研究[J].摩擦學學報,2007,27(5):401-405.
[11] 楊金波,劉玉玲,劉效巖,等.緩蝕劑在銅化學機械拋光過程中的作用研究[J].摩擦學學報,2007,27(5):404-405.
[12] 汪海波,俞沁聰,劉衛麗,等.工藝對藍寶石化學機械拋光的影響[J].功能材料與器件學報,2010,16(3):206-210.
[13] 董伯先.CVD金剛石膜化學機械拋光液的研制[D].大連:大連理工大學,2008.
[14] 李巖,康仁科,高航,等.碲鋅鎘晶體高效低損傷CMP工藝研究[J].人工晶體學報,2009,38(2):416-421.
[15] WRSCFHKA P,HERNANDE J,HSU Y,et al.Polishing parameter dependencies and surface oxidation of chemical mechanical polishing of Al thin films[J].Journal of the Electrochemical Society,1999,146(7):2689-2696.
[16] WEI E F,CHAO C A C ,YAN D L,et al.Passivation layer effect on surface integrity induced by Cu-CMP[J].Thin Solid Films,2011,519(15):4874-4879.
[17] 胡偉,魏昕,謝小柱,等.CMP拋光半導體晶片中拋光液的研究[J].金剛石與磨料磨具工程,20006,156(6):78-80.
[18] 李慶忠,金洙吉,張然,等.分散劑對銅CMP材料去除率和表面度影響的實驗研究[J].潤滑與密封,2007,32(3):70-72
[19] 宋曉嵐,王海波,曲鵬,等.水相體系納米γ-Al2O3漿料的分散穩定性能研究[J].材料科學與工藝,2005,13(5):506-508.
[20]郭權峰.二氧化硅介質層CMP拋光液配方研究[D].大連:大連理工大學,2005.
[21] 李薇薇,檀柏梅,周建偉,等.集成電路多層銅布線阻擋CMP技術與材料[J].半導體技術,2006,31(5):334-345.
作者簡介
鄒微波,男,1986年生,碩士研究生。研究領域:精密超精密加工。


 手機資訊
手機資訊 官方微信
官方微信








 豫公網安備41019702003646號
豫公網安備41019702003646號