
國慶期間半導體行業也有好消息傳來。據清華大學新聞網消息,由清華大學機械系路新春教授帶領清華大學成果轉化項目公司華海清科研發的首臺12英寸超精密晶圓減薄機Versatile-GP300正式出機,發往國內某集成電路龍頭企業。該裝備是路新春教授團隊與華海清科繼解決國內集成電路CMP裝備“卡脖子”問題后的又一突破性成果,將用于3D IC制造、先進封裝等芯片制造產線,滿足12英寸晶圓超精密減薄工藝需求。

據華海清科官網信息,Versatile-GP300是公司研制的用于12英寸晶圓減薄拋光一體機,通過新型整機布局集成超精密磨削、CMP及后清洗工藝,配置先進的厚度偏差與表面缺陷控制技術,提供多種系統功能擴展選項,具有高精度、高剛性、工藝開發靈活等優點。可基于Versatile-GP300拓展和研發多種配置,滿足3D IC制造、先進封裝等領域的晶圓減薄技術需求。
晶圓減薄為何如此重要?
伴隨著晶圓尺寸的增大,其厚度也相應增厚,這是為了保證晶圓在制造過程中具有足夠的強度。比如6英寸和8英寸的晶圓厚度是625微米和725微米,而12英寸的厚度達到775微米。但另一方面隨著電子產品小型化的驅動,集成電路尺寸不斷微縮,特別是3D、SiP等先進封裝等技術的發展,對芯片的厚度提出更高的要求,基本要求就是越薄越好。
對一個厚度725微米的12英寸晶圓,其電路層的有效厚度一般為5-10微米,極限厚度也就是20-30微米,而占總厚度90%以上的襯底材料僅是為保證晶圓在制造、測試和運送過程中有足夠的強度。因此電路層制作完成后,在封測階段 首先要對晶圓進行背面減薄,使其達到所需的厚度,然后再進行后續的劃片等工序:

晶圓減薄后對芯片有以下優點:
第一是芯片散熱效率顯著提高。隨著芯片結構越來越復雜,集成度越來越高,晶體管數量大幅增加,散熱已逐漸成為影響芯片性能和壽命的關鍵因素。顯然更薄的芯片有利于熱量從襯底導出。
第二是減薄后的芯片可以減少芯片封裝體積,可以讓芯片尺寸更小。
第三是減少芯片的內部應力。芯片厚度越厚,其工作過程中由于熱量的產生,使得芯片背面產生內應力,較大的內應力會讓芯片產生破裂。
除此以外,更薄的晶圓還可提高芯片的器件性能和提高后續劃片加工的成品率。
晶圓減薄的原理及常見技術
在半導體工業發展中業界推出了諸如磨削、研磨、CMP、干式拋光、電化學腐蝕、濕法腐蝕和等離子輔助化學腐蝕(PACE)、常壓等離子腐蝕(ADPE)等很多減薄技術,目前常用的是磨削、CMP、濕法腐蝕、ADPE和干式拋光等五種。
磨削是目前晶圓背面減薄的主要手段,其基本原理是通過旋轉的金剛砂輪對晶圓背面進行磨削,金剛砂輪基材通常有陶瓷、環氧樹脂。磨削由于效率高,減薄后的晶圓平整度好,成本較低,表面加工質量可以滿足一般集成電路封裝技術要求,成為最常見的一種減薄技術。
磨削的技術路線主要有旋轉工作臺磨削技術和晶圓自旋轉磨削技術兩種,其中旋轉工作臺磨削技術起步較早,在上個世紀70年代就已經用于100mm以下晶圓背面減薄。目前這種技術也主要用于200mm及以下晶圓背面減薄工藝。
旋轉工作臺磨削技術的基本原理是:磨輪先向下運動,獲得一個預定的磨削厚度后工作臺緩慢、均勻地平移,載片臺便獲得一個均勻的劃切進給速度。當載片臺上的晶圓從進入高速旋轉的磨輪到旋出高速旋轉的磨輪時,便實現了一次磨削過程:

晶圓自旋轉磨削技術于80年代提出,主要是克服了旋轉工作臺磨削技術對更大尺寸晶圓磨削存在局限性的問題。晶圓自旋轉磨削技術的基本原理是:在尺寸略大于晶圓的工件轉臺上,晶圓通過真空吸盤夾持在工件轉臺中心,杯形金剛石磨輪工作面的內外圓周中線調整到晶圓的中心位置,磨輪和晶圓繞各自的軸線回轉,磨輪垂直向下進行縱向切入磨削,也就是所謂的in-feed:

磨削深度Tw與磨輪軸向進給速度f和晶圓轉速Nw之間存在如下關系:Tw=f/Nw,可以看出對給定的磨輪軸向進給速度,提高晶圓轉速便可以減少晶圓磨削深度。
晶圓自旋轉磨削技術的優點是:
第一:在加工脆性材料時,當磨削深度小于某一臨界值時,在給定的軸向進給速度下如果工作臺轉速足夠高,便可以實現極微小磨削深度,也就是可實現延性域磨削。
第二:通過同時提高晶圓轉速和磨輪軸向進給速度,可以在保持與普通磨削同樣的磨削深度下達到較高的材料去除率,磨削效率較高。
第三:因為磨輪與晶圓的接觸長度、接觸面積、切入角不變,磨削力恒定,加工狀態穩定,可以避免晶圓出現中凸或塌邊情況。
第四:磨輪旋轉速度高于晶圓轉速,因此磨輪的磨損對晶圓平整度影響較小。
第五:晶圓自旋轉磨削設備結構緊湊,容易實現多工位集成,可以和拋光裝置集成一起,實現磨削拋光一體化。
基于上述優點,在200mm以上的晶圓背面減薄中,晶圓自旋轉磨削技術取代旋轉工作臺磨削技術,成為主流技術。
啰嗦一句,相比技術路線復雜的光刻技術,磨削技術目前就上述兩種技術路線,技術確定性很強,因而華海清科就算起步較晚,只要相應的技術獲得突破,設備性能能達到技術要求,設備能被客戶采用,便就有了一定的市場空間。
晶圓減薄設備典型結構及主要技術要求
因為采用晶圓自旋轉磨削技術的減薄機可以集成拋光,因此一體化減薄機在200mm以上的晶圓減薄中成為很典型的設備,比如華海清科此次推出的Versatile-GP300以及行業巨頭日本DISCO的DGP8761全自動300mm三軸四卡盤研削拋光一體機。
在如下圖的一體化減薄機中,左邊是磨拋主體,集成了磨削和拋光功能,其通過一個帶有4個真空吸盤的大圓盤回轉臺的360度旋轉,使晶圓在不用離開真空吸盤的情況下就可以順次移送到粗磨、精磨、拋光等不同的加工工位,完成了整個減薄過程:

這種一體化的設計完全克服了磨片后晶圓嚴重翹曲造成的難以搬到拋光機的問題,也避免了磨片后嚴重翹曲使表面損傷擴大甚至破裂的風險。
日本DISCO是全球領先的減薄拋光設備供應商,其DGP8761三軸四卡盤全自動研削拋光機也是一種集成磨削和拋光的一體化減薄機,其加工過程是用機械手臂將晶圓從晶圓盒中取出,放到中心定位臺上進行中心定位;用T1取物手臂將晶圓搬運到工作臺上;進行粗研磨加工;進行細研磨加工;進行干式拋光加工去除殘余應力;用T2取物手臂將晶圓從工作臺上轉移到離心清洗臺上;進行清洗和干燥;將晶圓轉移到貼膜機上。
DGP8761可穩定實現厚度25微米以下的12英寸晶圓減薄工藝,通過優化搬運部機構布局縮短了加工作業時間,提高了效率:
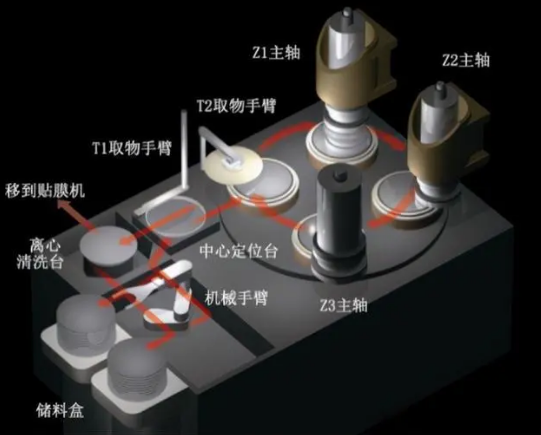
減薄機的主要質量要求是:
第一:擁有晶圓完整性,無破損;
第二:達到晶圓厚度精度及超薄化能力要求;
第三:達到晶圓表面粗糙度要求;
第四:達到晶圓表面損傷層厚度(SSD)要求;
第五:晶圓厚度一致性要求。
減薄機的主要性能指標也主要圍繞上述要求,比如DISCO的DFG8540和DFG8560,除了可加工的晶圓直徑、減薄技術等,重要的技術指標就有磨削精度,且細分出片間誤差、總厚度精度等指標:

當然衡量減薄機最粗暴的技術指標還是減薄厚度,比如DISCO的設備就可達到最低5微米的減薄厚度,雖然因為加工成本等原因并未普及,但5微米的水平也說明了DISCO的技術水準。
國產減薄機發展現狀:正處大規模產業化前夜
路新春教授團隊自2000年起便開展了CMP基礎研究,并承擔了國家重大科技攻關任務十余項,并通過華海清科這個產業化公司相繼推出了國產8英寸、12英寸CMP設備,打破了國外對該領域的壟斷。目前華海清科CMP設備實現28nm工藝量產,并具備14-7nm工藝拓展能力。
相比CMP,減薄機在華海清科的產品線中屬于拓展產品,因為有了減薄與拋光技術的集成趨勢,公司順理成章的將業務拓展至減薄設備領域,推出了Versatile-GP300減薄拋光一體機。
不過目前華海清科的減薄機還沒有貢獻營收,2017-2020年其營收為0.19億元、0.36億元、2.11億元和3.86億元,其中CMP設備貢獻的營收為0.14億元、0.32億元、1.95億元和3.53億元,其余來自配套材料及技術服務。截止2020年公司累計銷售300系列CMP設備33臺,200系列CMP設備1臺:

除了華海清科,國內還擁有減薄機研發能力的就是中國電科裝備旗下的中科電,其國家02專項“300mm超薄晶圓減薄拋光一體機研發與產業化“項目在2020年4月通過科技部正式驗收,標志著國內在集成電路高端裝備自主創新進程上實現新的突破。相關消息顯示,中科電減薄一體機是國內首臺擁有自主知識產權并滿足大生產的300mm減薄拋光一體機,具備晶圓粗磨、精磨、非接觸測量、拋光、清洗、傳輸和保護膜處理等全自動流片能力。

總體上華海清科和中科電已經在減薄設備上取得重大突破,下一步就是如何實現大規模產業化,提升市占率。


 手機資訊
手機資訊 官方微信
官方微信










 豫公網安備41019702003646號
豫公網安備41019702003646號